

时间: 2024-02-24 来源:产品知识
进程中,无铅锡膏可被用于基板凸点制造、模块及板级衔接等。在实践使用中应挑选什么样的无铅锡膏呢?
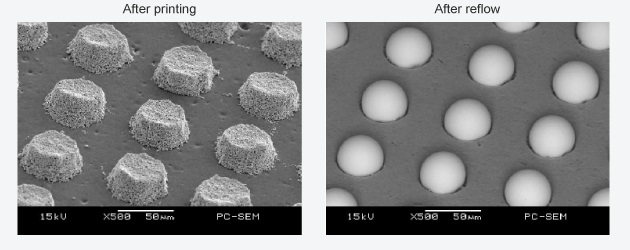
因为无铅锡膏性质特色,无铅锡膏许多特性间存在需求取舍的对立联系,这就造成了不行能有完美的产品,而应该要依据工艺特性挑选锡膏。例如,当选定合金焊料后,若要增大锡膏在被焊金属外表的潮湿性,就需求增大锡膏助焊剂的活性,而活性的增大就会增大焊接后被焊外表被助焊剂残留物腐蚀的或许。

还要考虑倒装芯片屡次阶梯回流的要求。芯片倒装焊接后,还有必要进行模块或板级互联,保持焊料熔点层级要求必须在挑选锡膏是考虑。
热疲惫牢靠性、下跌冲击牢靠性以及电搬迁牢靠性等是影响倒装芯片互联结构牢靠性的重要影响要素。
有研讨标明,关于不同周期的热循环,不同合金成分锡膏焊点所显现的焊点疲惫寿数不同。在0~100℃、120min的长周期热循环条件下,低Ag含量[2.1%(质量分数)]无铅锡膏焊点的热疲惫寿数最长,而在0~100℃、30min的短周期热循环条件下,高Ag含量[3.8%(质量分数)]无铅锡膏焊点的疲惫寿数最长。可见,在选用锡膏时还应该要依据工艺条件挑选正真合适的锡膏进步牢靠性。
倒装芯片封装应挑选什么样的无铅锡膏是一个需求多方面考虑的问题,既要包含工艺条件又要包含锡膏特性。挑选一个合适的倒装芯片无铅锡膏关于SMT等工艺具有极端严重的含义,不能盲目挑选,需求具体咨询相关专业工程师比较牢靠,福英达乐意为此供给免费的咨询解决方案,欢迎垂询!
共读好书 敖国军 张国华 蒋长顺 张嘉欣 (无锡中微高科电子有限公司) 摘要:
结构设计 /
工艺简介 /
具体介绍了FC技能,bumping技能,underfill技能和substrate技能,以及
的锡膏? /
上的凸点直接将元器件朝下互连到基板、载体或许电路板上。引线键合的衔接方法是将
技能原理图解 /
技能因为具有较高的单位面积内 I/O 数量、短的信号途径、高的散热性、杰出的电学和热力学功能,在电子
技能的优缺点有哪些 /
工艺流程 /
的应战 /
的I/0 焊盘上直接堆积,或许经过 RDL 布线后堆积凸块(包含锡铅球、无铅锡球、铜桂凸点及金凸点等),然后将
工艺 /
本文要点将引线键合衔接到半导体的进程能够依据力、超声波能量和温度的使用进行分类。
改进散热 /
【国产FPGA+OMAPL138开发板体会】(原创)7.硬件加速Sora文生视频源代码
【昉·星光 2 高功能RISC-V单板计算机体会】以容器的方法装置 HomeAssistant
 米乐m6棋牌官网最新版
米乐m6棋牌官网最新版